超細線軟性電路板 (Ultra-Fine-Line Flex)
PMR預鑽孔技術(Pre-drilled Technology)預鑽孔尺寸可達via < 25um,實現線寬距達10/10um,可用於高密度電路設計。
| Min Line / Space (um) |
25/25 | 15/15 | 10/10 |
|---|---|---|---|
| Trace Height (um) |
4~50 | 2~20 | 1~20 |
| Total pitch variation in 50mm.(%) | < 3% | < 3% | < 3% |
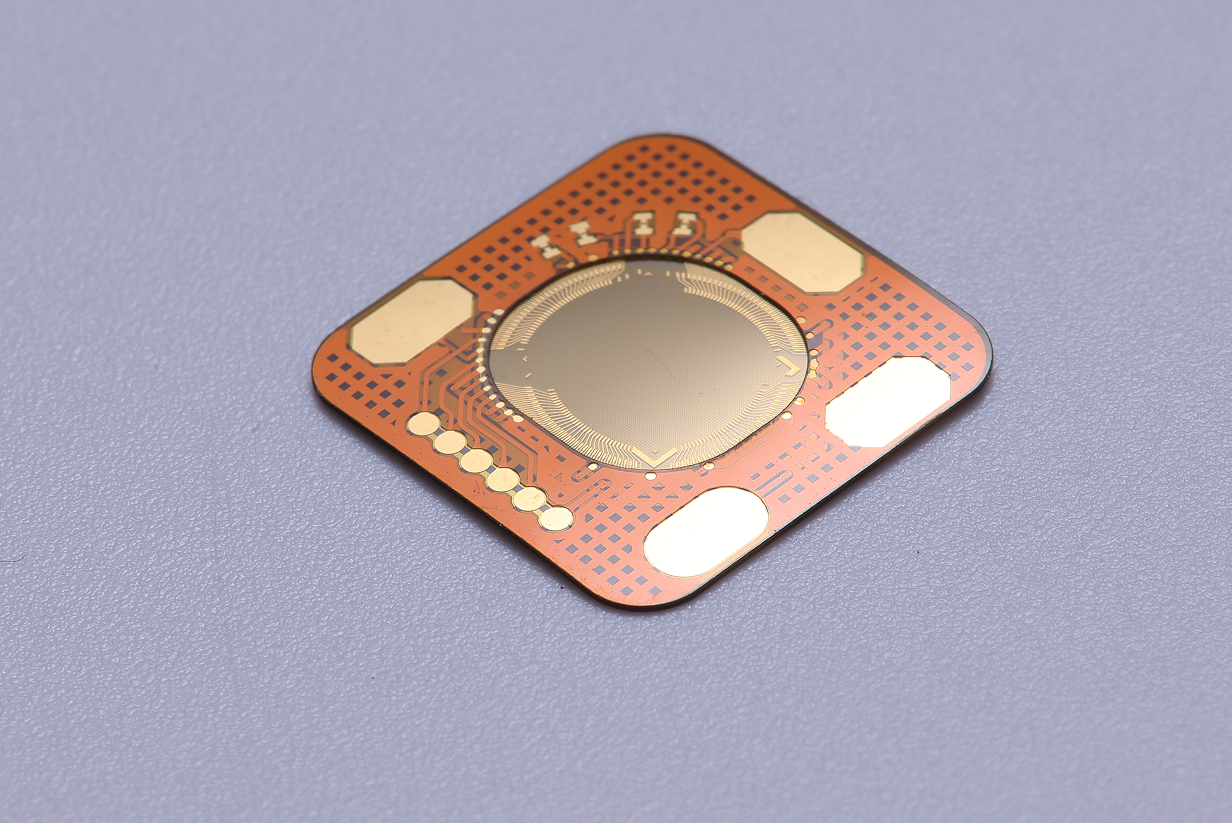
● 多層能力 (Multi-Layer Flex)
多層板(Multi-Layer Flex)的設計可提升線路設計的完整性,可減少電路板面積,提高電子設備的集成度
Capability : 3~6 Layers ( 層 )
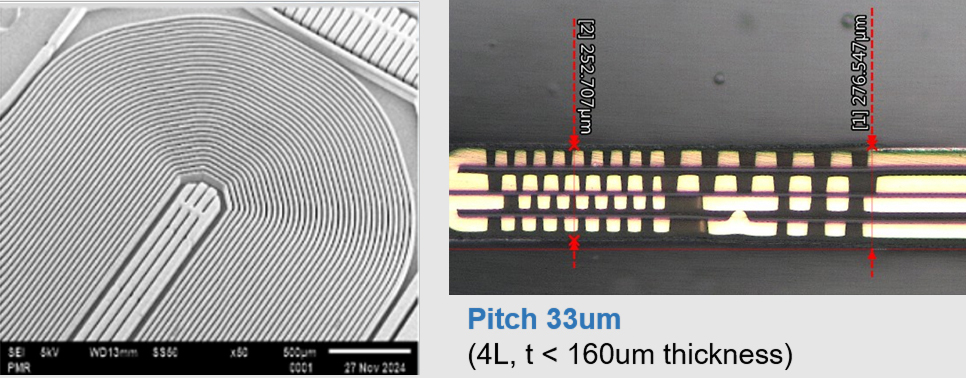
● 超薄 (Ultra-Thin Flex)
Ultra-Thin Flex(超薄軟性電路板)是一種極薄且,具高度柔軟性,適用於 微小空間設計,有利於增加空間有效使用率。
- Capability
- PI厚度 : min. 5um
- 線路厚度 : min. 5um
- 總體厚度: 4-layer total thickness < 50um


高密度微孔電路板 (High-Density Micro-via Board)
聚醯亞胺膜(Polyimide, PI)上預鑽孔技術(Pre-drilled Technology)可提供快速與低成本的方式達到微孔(Via小於25um的孔徑)的製作,達到超高密度(20KK/m2)微孔產品之需求,在通孔密度與通孔良率方面遠勝傳統銅箔基材(FCCL)上鑽孔方式。
● Capability
| 通孔密度 | VIA Density(VIA/m²) | |
|---|---|---|
| 高密度 | High Density | 500 K/m2 |
| 極高密度 | Super High Density | 5,000 K/m2 |
| 超高密度 | Ultra High Density | 10,000 K/m2 |
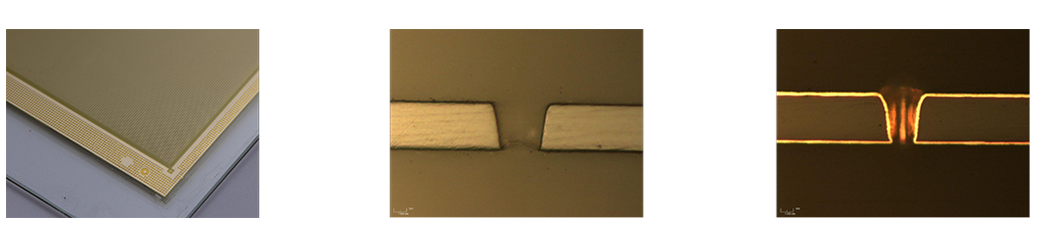
玻璃基軟性電路板 (Flex-On-Glass Substrate)
柔軟與易彎折的軟性印刷電路板FPC (Flexible Printed Circuit) 難用於高精度晶粒封裝(ex. Flip Chip),將FPC貼於玻璃載板(glass carrier)可以克服FPC高精度控制問題, FOG (Flex-On-Glass Flexible)可達到極細、極薄、極平、極準的產業要求,下游製程完成後可輕易脫離玻璃載板,FOG可提供最高精度的極致與高良率的FPC軟性印刷電路板 (Flexible Printed Circuit)應用。
● Capability
- Panel size尺寸 : 110*75mm~510*515mm
- Laminate Accuracy疊層精度 : < 50µm
- Flatness平整度 : < 2um
- 膠材選用 : CDF(冷解膠)/TDF(熱解膠)